





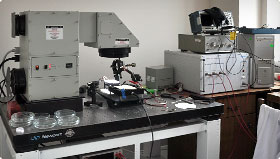


Вторичный ионный масс-спектрометр IMS-4F
Введение в SIMS

Технология SIMS обеспечивает уникальную комбинацию чрезвычайно высокой чувствительности для всех элементов от водорода до урана и выше (уровень обнаружения до уровня ppb для многих элементов), высокое послойное разрешение (до 40 нм) и низкий уровень фона, что позволяет достигать высокий динамический диапазон (более 5 порядков). Этот метод является «разрушающим» по своей природе, т.к. происходит распыление материала на площади растра от 10х10 до 500х500 микрон. Метод SIMS может быть применен к любому типу твердого материала (изоляторы, полупроводники, металлы), которые могут храниться в вакууме.
В то время как статический SIMS концентрируется на первом верхнем монослое, обеспечивая в основном молекулярную характеристику, в динамическом режиме SIMS исследуется объемный состав и глубинное распределение микроэлементов с разрешением по глубине от нанометра и выше.
Прибор SIMS оснащен первичными ионными пучками кислорода и цезия с целью усиления, соответственно, положительной и отрицательной интенсивностей вторичных ионов.
Одним из основных применений динамического SIMS является углубленный анализ распределения микроэлементов (например, легирующих примесей или примесей в полупроводниках). Ионная энергия удара регулируется в зависимости от глубины и требуемого разрешения глубины. Низкая энергия (от 500 эВ) используется для уменьшения смешения атомов из-за каскадов столкновения и улучшения разрешения по глубине вплоть до нанометрового уровня. Высокая мощность (до 20 кэВ) выбирается для более глубокого исследования (десятки микрон), увеличения скорости распыления и улучшения пределов обнаружения.
Анализ редкоземельных элементов
.png)
При анализе редкоземельных элементов в образцах минералов приходится иметь дело с несколькими молекулярными наложениями чрезвычайно близких масс, которые не могут быть разделены с использованием типичных условий с высоким разрешением.
Для решения таких проблем с наложением пиков масс необходима фильтрация энергии вторичных ионов с хорошо контролируемой полосой пропускания энергии. Техника фильтрации энергии основана на том, что распределение энергии является более узким для многоатомных ионов по сравнению с моноатомными. Путем перемещения энергетической щели с оптической оси или путем смещения приложенного к образцу напряжения можно выделить моноатомные ионы из ионов изобарического кластера.
Послойный анализ
.png)
В полупроводниковой технологии быстро меняются материалы и, следовательно, аналитические задачи. Благодаря своим выдающимся возможностям послойного анализа, CAMECA IMS-4f широко используется для мониторинга легирующих примесей в полупроводниковой промышленности и применяется для различных материалов. Среди инструментальных преимуществ нашего прибора: два источника ионов высокой интенсивности (Cs + и O2 +), высокая чувствительность и высокое разрешение по массам.
Отличные пределы обнаружения для глубоких имплантаций
Для глубоких имплантаций послойные профили глубиной до нескольких микрон можно анализировать в с высокой чувствительностью и достаточным динамическим диапазоном. Для трех основных легирующих примесей Si (B, P и As) может быть достигнут высокий предел обнаружения. Предел обнаружения улучшаtтся при увеличении скорости распыления.
Слева: Фосфор в кремнии - отличный предел обнаружения для глубоких имплантатов.
Оптимизированное разрешение глубины для мелких имплантаций
На CAMECA IMS-4f энергия удара может снижаться до 500 эВ, обеспечивая отличное разрешение по глубине, сохраняя при этом хорошую чувствительность. Поэтому IMS 4f можно использовать для характеристики послойного распределения примесей в мелкоимплантированных образцах или тонкослойных структурах.
Справа: Мелкие имплантаты из бора в кремнии - отличное разрешение по глубине для профилирования низкой глубины.
Контроль чистоты в исходном сырье
.png)
Производство устройств на солнечных элементах на основе кремния требовательно к чистоте. Контроль качества процесса очистки Si является обязательным для обеспечения высокой производительности.
Пределы обнаружения
CAMECA IMS 4f обеспечивает количественное измерение концентрации примесей микроэлементов в исходном материале с пределами обнаружения от ppm и более в зависимости от элемента, подлежащего анализу.
Пределы обнаружения SIMS в кремнии для анализируемого материала показаны в таблице ниже. Производительность CAMECA IMS 4f особенно привлекательна для анализа основных примесей Si (B, P, As), а также металлов (Al, Cr, Fe, ...).

Наименьшие пределы обнаружения достигаются для легких элементов благодаря оптимизированным условиям сверхвысокого вакуума, полученным объединением криосистемы с турбомолекулярной откачкой в аналитической камере. График вверху страницы демонстрирует превосходные пределы обнаружения кислорода в кремнии.

