





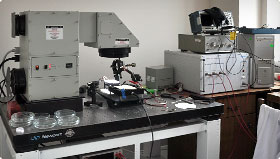


Просвечивающий электронный микроскоп Tecnai G2 F20 U-TWIN
Просвечивающий электронный микроскоп Tecnai G2 F20 U-Twin (фирма FEI, Нидерланды) в базовой комплектации позволяет получать изображения с атомарным разрешением.
Изображения фиксируется 16-ти мегапиксельной цифровой матрицей с физическими размерами 60 х 60 мм2. Предельное увеличение 1 100 тысяч, с линейным разрешением 0,12 нанометра.
Кроме получения изображений в рамках геометрической оптики, на просвечивающем электронном микроскопе Tecnai G2 F20 U-Twin можно использовать режим элетронографа с изменяемой рабочей длиной.
По дифракционным картинам от поликристалла можно проводить фазовый анализ вещества, а по дифракционным картинам от монокристалла можно получить информацию о текстуре исследуемого образца.
Виды анализа методом сканирующей электронной микроскопии:
-
Получение изображений методом ПЭМ образцов наноразмерных объектов:
- наночастиц (нанопорошков),
- наностержней,
- нановолокон,
- нанотрубок,
- нанопроволок,
- нанодисков
с пространственным разрешением до 0,2 нм. - Анализ изображений с получением численных данных о размерах и форме нанообъектов, степени их агломерируемости и распределении по размерам.
- Получение изображений методом ПЭМ структуры образцов наноструктурных материалов с пространственным разрешением до 0,2 нм.
- Получение стереоизображения топографии поверхности
- Анализ изображений с получением численных данных о размерах и форме нанокристаллитов (гранул), пор, межкристаллитных границ и других особенностей структуры.
- Получение изображений методом ПЭМ структуры поперечных сечений и поверхностей образцов тонкослойных наноструктурных объектов (проводящих и непроводящих), в том числе тонких пленок, покрытий, наночипов и электролит-электродных структур, с пространственным разрешением до 0,2 нм.
- Анализ изображений с получением численных данных о размерах слоев, о размерах и форме нанокристаллитов (гранул), пор, межкристаллитных границ, межслоевых интерфейсов и других особенностей структуры.
- Анализ распределения химических элементов в объекте (на основе рентгеноспектрального анализа);
- Исследование точечных и линейных дефектов материалов – вакансий и дислокаций;
- Анализ распределения потенциалов в сложных микроизделиях (вольтов контраст);
- Исследование распределения магнитных полей в образце (магнитный контраст);
- Метрология микроизделий.
Сведения о сертификации:
|
| ||
| скачать pdf | скачать pdf | скачать pdf
|
|
| ||
| скачать pdf | скачать pdf | скачать pdf
|
ГОСТ Р 8.697-2010 Государственная система обеспечения единства измерений. Межплоскостные расстояния в кристаллах. Методика выполнения измерений с помощью просвечивающего электронного микроскопа









